室温原子層堆積(Cool ALD®)
室温原子層堆積法は山形大学の廣瀬教授らが開発した技術で、弊社ではその技術およびノウハウを含めて全面的に導入して、実用化を進めています。
原子層堆積(ALD)は、有機金属材料ガスと酸化性ガスを真空容器に交互に充満させることで、固体基板に酸化物薄膜を非常に均一に制御性よく形成する技術です。従来、原子層堆積装置は基板表面での反応のために250℃から300℃程度の基板加熱が必要でしたが、山形大学廣瀬教授らはプラズマで発生させた酸化ガスを利用することで、室温での原子層堆積が可能になりました。この優れた低温性は、従来従来熱に弱くてALDが適用されていなかった有機エレクトロニクスの分野にもこの技術が利用できることを示唆するものです。
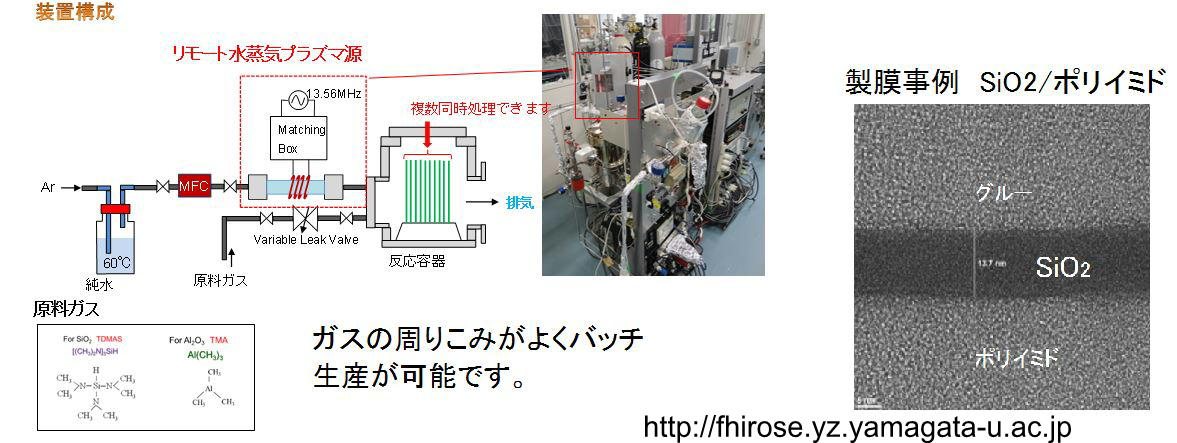
室温原子層堆積法は、成膜温度が室温であるため、従来熱に弱くて適用できなかった精密部品、プラスティック、樹脂などにセラミックス(金属酸化物)の優れた物性を付与できる可能性があります。したがって、防食、ガスバリア、機能性表面付与など様々応用が期待されます。
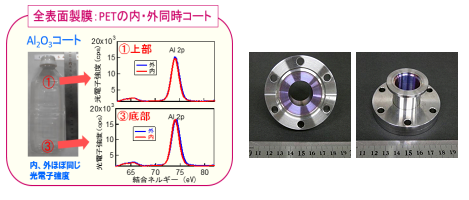
PETボトルへのコーティング事例 真空部品へのコーティング事例
山形大学廣瀬研究室提供http://fhirose.yz.yamagata-u.ac.jp
よく室温でつけた膜は密着性がわるいのではないかと質問を受けます。下地の材料によりますが、Si基板での実例ですと、テープテストに耐える程度の密着力はあるようです。私たちは製膜初期に独自の処理で膜と下地との化学結合を図っております。
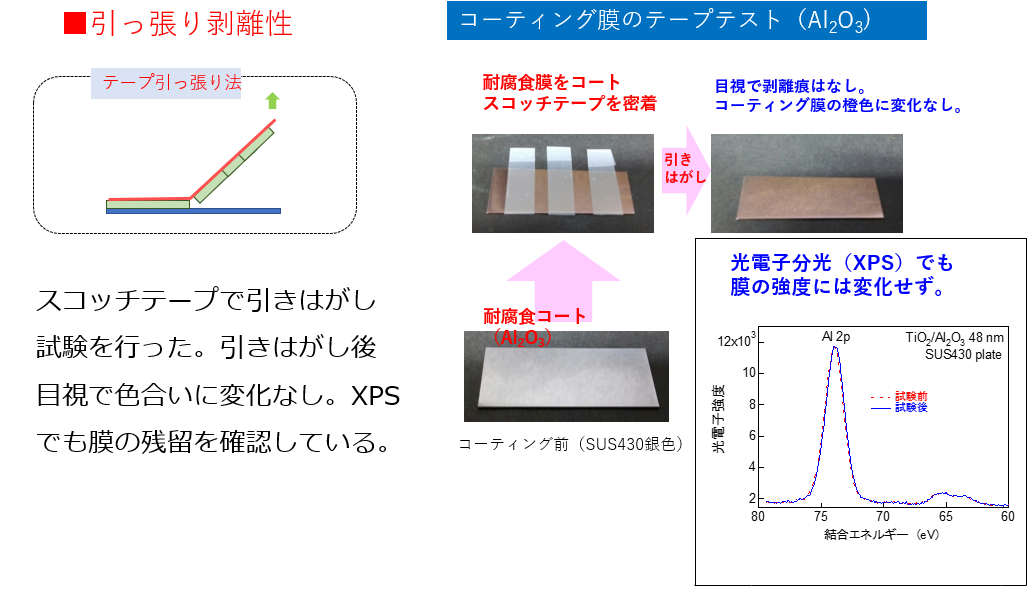
テープ密着試験例 (山形大学廣瀬研究室提供)
このほか室温原子層堆積法については、山形大学廣瀬教授らが次の文献を発表されています。
SiO2事例 M. Degai et al., Thin Solid Films, 525 (2012) 73–76.
TiO2事例 K.Kanomata et al., Applied Surface Science, 308 (2014) 328–332
Al2O3事例 電子情報通信学会和文論文誌C Vol.J98-C,No.1,pp.1-7,Jan. 2015.
HfO2事例 K.Kanomata et al., Journal of Vaccum Science and Technology, A33(2015)01A113.
ZrO2事例 K.Kanomata et al., JApplied Surface Science 387(2016)497–502
Ga2O3事例 P. Pansila et al., IEICE Transactions on Electronics
Vol.E98-C, No.5, pp.382-388.
TiO2ナノ微粒子事例 Kikuchi et al., J. Vac. Sci. Technol. A 35(1), 01B121, Jan/Feb
2017
色素電池電極 T. Imai et al., Journal of Vacuum Science & Technology A36,
01A106 (2018).
Nb2O5事例 K. Yoshida et al., Journal of Vacuum Science and Technology, A 37, 060901
(2019)
総説 廣瀬文彦 室温原子層堆積法とその応用 応用物理 第86巻 9号, pp.796-800, 2017年
最新の情報はGoogleScholar等でご確認ください。
室温原子層堆積の優位性
こちらの方式は従来の原子層堆積や、スパッタ蒸着と異なり次のような優位性があります。
まずは製膜温度が室温であることです。このため、製膜対象に対してダメージがすくなく、精密部品、プラスティック、微細加工ウェハ、樹脂部品への適用が可能です。また非常に飛程が長いラジカルをつかっている(仮説)ため、反応容器を1m級の大型にしても、万遍なくコーティングが可能であり、特にバッチ処理を得意としています。したがって、ウェハであれば1m容器で数百枚程度の同時処理、小さな電子部品では数千個を一度に同時処理が可能になります。ガスでの処理であるため、PVDと呼ばれる物理的なコーティングである、スパッタや真空蒸着ではできない、全表面被覆も可能です。堆積速度は現在も向上のために研究努力をしているところですが、膜種によりますが、10nm/h時間程度を達成しており、数十nm程度のコーティングを大量に行う処理には広く活用いただいているところです。
| Cool ALD | 熱ALD | プラズマALD | CVD | スパッタ | |
|---|---|---|---|---|---|
| 膜種 | ほぼ全酸化物 | ほぼ全酸化物 | ほぼ全酸化物 | ほぼ全酸化物 | ほぼ全酸化物 |
| 処理対象 の制限 |
制限はありません ほぼ全材種 |
高温(120~300℃)に耐えるもの | プラズマダメージに耐えるもの | 高温(100~ 300℃)に耐えるもの | プラズマダメージと高温に耐えるもの |
| 製膜温度 | RT | 120~400 ℃ | RT~400 ℃ | 300~500 ℃ | RT~400 ℃ |
| 製膜速度 | 膜種によりますが 10 nm/h |
装置によりますが ~10 nm/h |
装置によりますが ~10 nm/h |
100nm/h | 100nm/h |
| 同時処理数 | 無制限 (処理容器サイズによる) |
無制限(均熱領域で制限) | 枚葉 | 無制限(均熱領域で制限) | 枚葉 |
| 複雑形状堆積 | 全面均一 | 全面均一 | 一面のみ | 全面均一 | 一面のみ |
| そのほか利点 | 高温容器が不要で低コスト |
大型室温原子層堆積装置
山形大学廣瀬研究室では、科学技術振興機構(JST)大学発新産業創出プログラム(START)とその事業プロモーターである野村ホールディングス株式会社の支援を受けて、世界最大クラスの室温金属酸化膜原子層コーティング装置を開発しました。当社では、この技術を受けて装置の製造および販売をてがけます。従来、原子層堆積は半導体製造での絶縁膜形成で活用されていましたが、300℃程度の熱処理が必要とされていました。廣瀬教授らは、これを室温(25℃)まで低温化することに成功し、半導体のみならず、熱に弱い電子部品や精密機械に適用することで部品を長寿命化させ、耐腐食性と向上させる研究を続けてきました。1m規模まで装置を大型化することに成功し、小さな部品であれは数千個程度、1m規模の長尺な部品を一括処理することが可能になり、量産現場での使用が可能になりました。

山形大学廣瀬研究室提供http://fhirose.yz.yamagata-u.ac.jp
室温原子層堆積可能膜種
殆どすべての金属酸化物膜に対応できます。これらの膜の多層化も可能です。ご相談ください。
| 膜種 | 用途 | 備考 |
|---|---|---|
| SiO2 | 絶縁膜、バリア膜、濡れ性付与、防食 | 半導体製造 電子デバイス |
| TiO2 | 光学膜、光触媒、濡れ性付与、生体親和膜、半導体膜 | 電子部品 光学部品 |
| Al2O3 | ハイバリア膜、防食膜、反射防止、太陽電池再結合抑制 | 部品保護、電子部品、 バリアフィルム |
| ZrO2 | High-k、光学膜、絶縁膜 | 半導体製造、デバイス、 光学部品 |
| HfO2 | High-k、光学膜、絶縁膜 | 半導体製造、デバイス、 光学部品 |
| Nb2O5 | 難腐食膜 | 金属部品 |
| ZnO | ハイバリア膜、薄膜トランジスタチャネル | 電子部品、デバイス |
| SnO2 | 薄膜トランジスタチャネル | 電子部品、デバイス |
| Y2O3 | high-k用途(開発中) | 電子部品、デバイス |
| Al2O3-SiO2 | イオン交換膜、イオン吸着 | 水質浄化 原子力汚染除去(開発中) |
| GaN | 半導体 | 電子デバイス |
| 窒化物膜 | 開発中 | 導電膜 |
室温原子層堆積膜の用途
室温原子層堆積は様々な用途で利用可能です。